2017年11月28日に、東京都の中央線の西荻窪駅の近くで、
エレクトロニクス実装学会で最新技術情報を知らせる以下のイベントがあります。
システム設計研究会「平成29年度第2回公開研究会」開催のご案内
このイベントでは、参加し易い無料懇親会があるので、
最新の技術情報を知っている講演者と直接に面識を持つチャンスが得られると思います。
(参考)日本で5Gの商用サービスは3年後の2020年に始まる。
NTTドコモとKDDIが2020年中の開始を表明しているほか、ソフトバンクも「2020年ごろを目指す」としている。
(なぜ5Gが必要なのか?)
今後はIoT化が急速に進み、身のまわりのありとあらゆるモノがインターネットに接続することで、トラフィック(通信回線を利用するデータ量)の急増が見込まれる。
(1)家庭の中に無数にある各種家電、
(2)ウェアラブルデバイス、
(3)自動運転カー、
(4)産業用ドローン
などがその代表格。
ほかにも、
(5)遠隔医療(診断)、遠隔手術(映像の8K化や立体化など)
(6)農業用センサー、
(7)道路や橋梁の異常検知センサー、
等等。
それらの機器がワイヤレスで通信を行うことは間違いなく、そこで5G通信網が必要。
(公開研究会のポイント)
(1)放送のニーズに忠実に従って開発し未来の画像デバイスが生まれた。放送以外にも広い応用が期待できる。
(2)5G技術に対応するべく世界が動いている技術の動きを知りたい。
(3)世界の技術のニーズに忠実に従う技術開発によって部品で大きな世界シエアを確保できた。そのように技術のニーズを曇り無く見たい。
(4) 技術のニーズに従って開発のただ中にある新技術を知る。
(参考)NHK技研公開2017展示資料の挨拶文から:
2020年には東京オリンピック・パラリンピックが開催されます。
NHKでは、 最高水準の放送・サービスを実現するために、視聴者の皆さまに新たな価値を提供できる サービスの創造に取り組んでいます。
その一翼を担うスーパーハイビジョンは、技研の20年に渡る研究成果が結実し、昨年、2016年8月に衛星による試験放送が開始され、
2018年の実用放送、2020年の本格普及に向けて着実な一歩を踏み出しました。
NHK技研 新機能デバイス研究部 後藤 正英
「3次元構造撮像デバイスの研究」
技研では、将来の立体映像などの撮影に期待できる高性能なカメラの実現に向けて、新しい概念の撮像デバ イスの研究開発に取り組んでいます。
3次元構造撮像デバイスの特徴
撮像デバイスの性能は、精細さに関わる画素数や、動きの滑らかさに関わるフレームレートなどで表さ れます。
従来の撮像デバイスでは、画素の列ごとに1つの信号処理回路があり、多数の画素の信号を1つず つ順番に処理して出力するため(列並列信号処理)、画素数を増やすと信号出力に時間がかかり、フレームレー トを高めることが難しくなります。
とりわけ立体映像の撮影には、現在のデバイスをはるかに超え る画素数が必要になるため、フレームレートを維持できなくなることが懸念されます。
3次元構造撮像デバイスは、受光部や信号処理回路を備えた複数の基板を積層した構造で、画素ごとに信 号処理回路を持ち、並列して信号処理を行います(画素並列信号処理)。
画素数に関わらず1回の信号処理 で1画面を出力できるため、多画素化と高フレームレート化の両立が可能です。
我が国の閉塞感を打破するにはどうしたらよいか?
ヒントは身近なところにあるのかもしれない。 撮像デバイスである。
CCD(Charge Coupled Device:電荷結合素子)やCMOSイメージセンサーは我が 国が圧倒的な強みを有する分野である。
撮像デバイスは,8Kスーパーハイビジョンやさらなる高精細・高機 能を目指しており,今後も確実に進展が期待できる。
画素数増大を目指すという観点からは,撮像デバイスは More Mooreに近いようにも見える。
一方で,人々を引き付ける立体映像の撮像やさまざまな高機能化を実現 するには,新原理による各種デバイスや新機能の搭載が必須である。
撮像デバイスは,CMOSトランジスター の微細化による高速化と高集積化の恩恵を享受しつつも,微細CMOSデジタル回路による新機能搭載や,裏 面照射などの新構造導入も進めており,More Than Moore やBeyond CMOSも巻き込んで総力を挙げて撮像 デバイスの超高性能化に挑んでいるという感がある。
すなわち,最先端技術に対して大いなる期待感が存在し ている。そして,その技術で生み出された鮮明で印象に残る美しい映像が,今度は見る者に期待感とわくわく 感をもたらす。
(平本俊郎 東京大学生産技術研究所 教授)
(参考)超高画質8Kは5分で67GB!映画祭で見た知られざるVRの世界に迫る
(参考)人間の目と同じ解像度のVR/AR/XRディスプレイ「20|20」を発表した
Varjoのディスプレイは70メガピクセルで1メガピクセルのOculus、Vive、Hololens、Magic Leapなどと比べ、70倍の画質を誇っている。
次世代コンピューティングプラットホームとしてVarjoのプロダクトは2017年終わりごろにリリースされる予定だ。
(参考)北海道の絶景を、2億ピクセルを越える超高画質な360°パノラマVRで楽しめる「北海道VRツアー」 の公開と、そのデータのライセンス利用の開始
(参考)3D-HD(立体ハイビジョン)遠隔医療支援システム
遠隔医療センターが、高度な技術が要求される眼科手術の様子を、
顕微鏡に装着した左目用と右目用のビデオカメラ(1920×1080画素、フルカラー、30 frame/sec)によって立体HD動画像として撮影し、
それを遠隔地の医療機関へ高品質かつリアルタイムに伝送できるシステムを開発しました。
(参考)来年度の診療報酬の改定で遠隔診療の保険適用対象を広げる。
遠隔画像診断サービスの市場の概況
遠隔画像診断サービスは1990年代後半に市場が形成されて以降、一貫して右肩上がりで成長してきました。
国内におけるサービス提供事業者は60社程度で、
①全国展開を積極的に進めている一般企業系、
②関連施設・系列病院を主なユーザとする大学病院系(大学発ベンチャー、NPO法人)、
③特定の地域で展開する小規模事業者
などで構成されています。
2008年ごろから急成長している大学病院系の読影グループは、関連病院への非常勤医師の派遣に代わって、遠隔読影サービスの利用が増えたことを背景に成長してきました。
西尾 俊彦
電機業界を揺るがすパッケージ革命
西尾俊彦氏の講師紹介
1988年より: 日本アイ・ビー・エム株式会社。野洲研究所にて世界初となるオーガニック基板へのフリップチップ実現の熱応力理論を導入。
1993年より: 先端実装技術アプリケーション開発。世界最先端性能(当時)のウエアラブルグラスなどのパッケージ開発を統括。
2003年より: IBM Distinguished Engineer (技術理事)。IBMが新事業として開始した技術コンサルティングサービスのパッケージ部門を統括。
2020年に向けて、IoTデバイスの台数が大幅に増加する見込みだ。そこで、新しい通信インフラの整備が必要になっている。モバイル通信ではデータ速度が最新のLTEに対して40倍以上の5Gモバイルの運用が始まる。モバイル端末のバンド幅も2019年には4倍の100GB/sを超える。そのデータ処理に対応するデータセンタサーバーも5倍以上の性能が必達である。
基幹のEthernetネットワークの速度も100GbEから400GbEへの高速化が求められる。
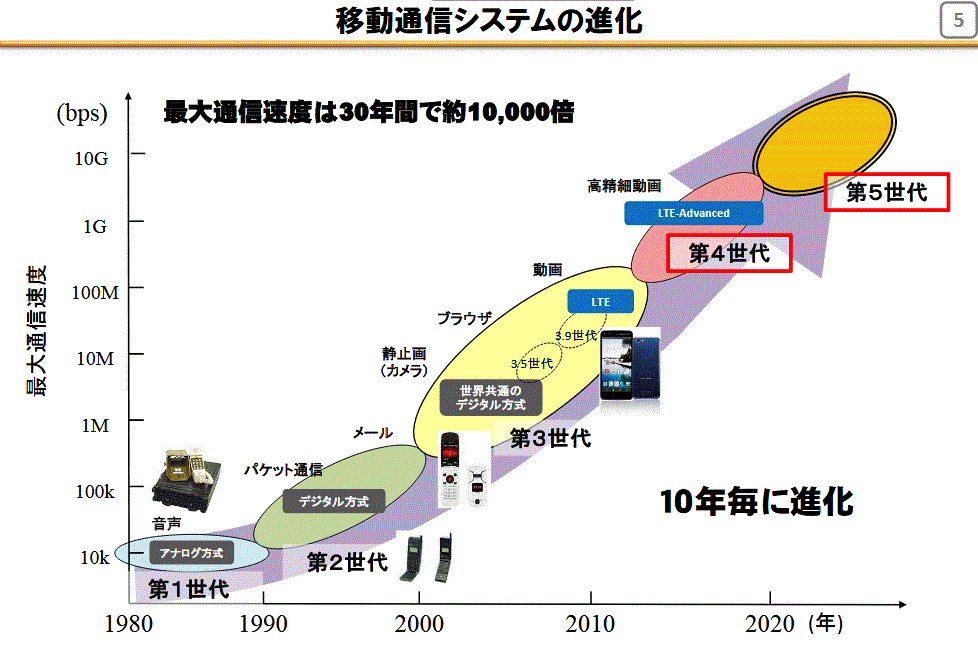
モバイル端末の分野でも、2020年までにメモリーのバンド幅を4倍以上に上げる必要があり、それを実現可能にするパッケージとしてFOWLP(Fan Out Wafer Level Package)に注目が集まっている。
FOWLPはフリップチップよりも電気特性が良く、薄型化した際の熱変形が少ないなどに優れたパッケージで、5年ほど前からモバイル端末用のRF、パワーアンプやベースバンドなどのIC向けに徐々に広がりを見せてきた。さらに、モバイル端末のアプリケーションプロセッサー(AP)にもFOWLPが採用される見込みとなり、いよいよモバイル端末用の半導体パッケージの主流になろうとしている。 電気特性や配線密度に優れたFOWLPは、自動運転に欠かせないレーダーには既に採用されており、次世代高速ネットワーク用途のマルチチップ構成にも開発が進むなど、さまざまなアプリケーションへの広がりを見せている。
一方、FOWLPの高性能化および薄型化を実現するファンアウト部分のコストが、現在の製造プロセスでは従来のフリップチップに比べてコスト高になっている。さらに、パッケージを支える役割であった基板が無くなることで、マザーボードからの応力の影響を受けやすくなるなどの懸念もある。
5G時代の半導体パッケージは技術もビジネスも激変
「5G時代の半導体を実現するパッケージ革命」の講師、西尾俊彦氏に聞く
iPhone7に採用されたFOWLP(Fan Out Wafer Level Package)は半導体のテクノロジーノードもメモリーバンド幅もそのままで、パッケージにより性能を1.4倍も引き上げた。FOWLPという優れたパッケージの導入により、ムーアの法則の終焉をパッケージが補完するというシナリオにおいて、大きなステップを示したことになる。
梶田 栄
スマートフォン(スマホ)の部品の村田製作所の世界シェア:
(電子回路のノイズを除去する「セラミックコンデンサー」はスマホに1台700個使われ、村田製作所の世界シェア4割だ。
通信制御に使う「SAWフィルター」で村田製作所が世界シェア5割を握る。)
ポストスマートフォンは?
スマートフォンの製品仕様の変化
IoT製品(自宅の見守り系センサー):窓の開閉状況や温度、湿度、照度、人感センサー、鍵の開閉状況。
IoTとは?
M2Mとは?
M2Mとセンサ
M2Mの全体像と市場
BLEの登場で一番のインパクトは低消費電力で動作可能なことだったが(機能や実装により異なってくるので一概には言えないが、ボタン電池1つで何ヶ月といった省電力性)、LPWAではさらにボタン電池で数年単位の動作を実現するという。
LPWA(Low Power, Wide Area)は、長距離伝送と低消費電力を特徴とするIoT(インターネット・オブ・シングス)向け通信技術の総称である。通信コストを現在のM2M(マシン・ツー・マシン)向け通信サービスの10分の1くらいまで下げられるかもしれないという期待もあり、注目を集めている。
既にフランスなどではSigfox社により全土にLPWAのネットワークが構築され、米国などでもLoRa規格によるLPWAの導入が始まっている(図表3-3-2-7)。
LPWA(Low-Power Wide Area)無線技術は、低い消費電力と長い通信距離が要求されることが多いIoT(Internet of Things)の実現を可能にします。
通信モジュール
電子部品の進化が携帯電話の小型化へ大きく寄与
極小セラミックコンデンサとは
極小電子部品の実装と課題
(参考)米クアルコム、5Gモデム搭載モバイル端末で毎秒ギガビット通信に成功
下石坂 望
IoT/IoE、ウエアラブル製品の急増にともなう多様な実装要求を克服する導電ペーストバンプによる低温ダメージフリー接合、かつ、狭ピッチ対応実装技術を研究しています。
コネクテックジャパンのコアテクノロジーであるMonster PAC技術は、従来技術の常識を覆す低温低荷重の実装技術であり、微細加工技術です。
また、Monster PAC技術によって、フリップチップボンダーをデスクトップサイズで実現できます。
そして、グローブボックスによる局所クリーン技術によって、高価なクリーンルームを不要にできます。
《 世界初10ミクロンピッチFCB 》
「世界唯一の技術、極低温・極低荷重のMonster PAC(r)で実現する10ミクロンピッチ接合」
(コネクテック、半導体実装工程を「卓上化」 - 低温低荷重接合で実現)
コネクテックジャパンは、パナソニック セミコンダクター社を退職した平田氏が2009年に設立。
国内大手メーカーの多くが半導体事業から撤退したことにより、リストラされた多くの技術者が力を発揮できない境遇に置かれているのが、現在の日本の状況であると指摘する平田氏。
「半導体業界の環境変化によって、技術力を持った30万人のリソースが今、国内にある。これは我々のようなベンチャー企業にとっては大きなチャンス」
と語り、そうした人材の積極的登用を行っていることも同社の特色であると強調する。
●先端半導体デバイスやMEMSにも適用可能なMONSTER PAC
○最先端の半導体実装課題を低温低荷重接合で解決
低温低荷重接合でこれまでなかったアプリケーションが可能になる
プロセス温度をさらに下げ、80℃にできれば、PETフィルム基板を含むほとんどすべての材料にフリップチップボンディングを適用できるようになる。このため現在は、接合温度80℃のプロセス開発を進めている。低温で確実に硬化する熱硬化性樹脂の開発がカギになるが、実現の見通しは立ってきているとしている。
(当ブログのコメント)
半導体部品が、卓上設備で製造できるようになると、今まで問題だった、半導体製造業界へ参入するための設備投資が高額という参入のハードルが低くなり、半導体産業が飛躍的に拡大する産業革命が起きるかもしれない。
その産業革命のトップにコネクテック社が位置していて、積極的に優秀技術者採用を進めているように見える。そのため、この時代にいる我々は、今後、コネクテック社が、ビルゲーツのマイクロソフト社の成長のように急速に成長するという、時代の変り目の変化を見ることになるかもしれない。
(参考)センサーの動向
センサーにおける小型化は、MEMS(微細加工)技術の活用で大きく前進している。デジタル気圧センサーでは、2×2.5×0.9ミリサイズ品が開発された。
ローパワーモード時1.8μAという低消費電流と高い検知精度(絶対圧力精度±0.05hPa)を達成している。
非接触温度センサーは、2.2ミリ角×0.9ミリサイズ品が登場。出力電圧は1ミリV。消費電流は2μA。
(参考)スマートグラス・スマートウォッチなどのウェアラブルデバイス業界において大本命と称されるイヤホン型の端末。
(参考)スマートグラスの肝は拡張現実(AR)にあり
2017年の世界ウェアラブルデバイス市場における腕時計型とリストバンド型の合計シェアは94.5%。腕時計型は、2021年までウェアラブル市場の大部分を占める見込みだ。手首装着型以外のウェアラブルでは、靴・衣類型と耳掛け型が急速に伸びるという。
エレクトロニクス実装学会で最新技術情報を知らせる以下のイベントがあります。
システム設計研究会「平成29年度第2回公開研究会」開催のご案内
回路・実装設計技術委員会
システム設計研究会
主査: 除村 均 (富士通アドバンストテクノロジ)
幹事: 齋藤 純一(シイエムケイ・プロダクツ)
システム設計研究会
主査: 除村 均 (富士通アドバンストテクノロジ)
幹事: 齋藤 純一(シイエムケイ・プロダクツ)
◆開催主旨
テーマ:
「2020年東京オリンピックに向けた最先端実装技術」
「2020年東京オリンピックに向けた最先端実装技術」
| 開催日時 | 2017年11月28日(火) 13:00~17:00 | ||||||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| 会 場 | 回路会館 地下会議室 JR中央線西荻窪駅下車徒歩約7分 〒167-0042 東京都杉並区西荻北3-12-2 TEL.03-5310-2010 | ||||||||||||||
| 講 演 |
※ 研究会後に会場で懇親会(無料)を予定しています。
| ||||||||||||||
| 定 員 | 100名(先着申込順 定員になり次第締切ます) | ||||||||||||||
| 参 加 費 | (テキスト代、 消費税込み)
注:クーポン(賛助会員向け)は1口1枚まで利用可能。
申し込み時にクーポン番号を記入しないと、利用できません。 必要事項をご記入の上、ご持参ください。
* 参加費は当日会場受付にて徴収します。釣り銭のないようにご準備をお願いします。
| ||||||||||||||
| 問い合わせ先 | cae_uketsuke\jiep.or.jp (メールアドレスは\を@に置き換えてください) |
このイベントでは、参加し易い無料懇親会があるので、
最新の技術情報を知っている講演者と直接に面識を持つチャンスが得られると思います。
(参考)日本で5Gの商用サービスは3年後の2020年に始まる。
NTTドコモとKDDIが2020年中の開始を表明しているほか、ソフトバンクも「2020年ごろを目指す」としている。
(なぜ5Gが必要なのか?)
今後はIoT化が急速に進み、身のまわりのありとあらゆるモノがインターネットに接続することで、トラフィック(通信回線を利用するデータ量)の急増が見込まれる。
(1)家庭の中に無数にある各種家電、
(2)ウェアラブルデバイス、
(3)自動運転カー、
(4)産業用ドローン
などがその代表格。
ほかにも、
(5)遠隔医療(診断)、遠隔手術(映像の8K化や立体化など)
(6)農業用センサー、
(7)道路や橋梁の異常検知センサー、
等等。
それらの機器がワイヤレスで通信を行うことは間違いなく、そこで5G通信網が必要。
(公開研究会のポイント)
(1)放送のニーズに忠実に従って開発し未来の画像デバイスが生まれた。放送以外にも広い応用が期待できる。
(2)5G技術に対応するべく世界が動いている技術の動きを知りたい。
(3)世界の技術のニーズに忠実に従う技術開発によって部品で大きな世界シエアを確保できた。そのように技術のニーズを曇り無く見たい。
(4) 技術のニーズに従って開発のただ中にある新技術を知る。
(参考)NHK技研公開2017展示資料の挨拶文から:
2020年には東京オリンピック・パラリンピックが開催されます。
NHKでは、 最高水準の放送・サービスを実現するために、視聴者の皆さまに新たな価値を提供できる サービスの創造に取り組んでいます。
その一翼を担うスーパーハイビジョンは、技研の20年に渡る研究成果が結実し、昨年、2016年8月に衛星による試験放送が開始され、
2018年の実用放送、2020年の本格普及に向けて着実な一歩を踏み出しました。
NHK技研 新機能デバイス研究部 後藤 正英
「3次元構造撮像デバイスの研究」
技研では、将来の立体映像などの撮影に期待できる高性能なカメラの実現に向けて、新しい概念の撮像デバ イスの研究開発に取り組んでいます。
3次元構造撮像デバイスの特徴
撮像デバイスの性能は、精細さに関わる画素数や、動きの滑らかさに関わるフレームレートなどで表さ れます。
従来の撮像デバイスでは、画素の列ごとに1つの信号処理回路があり、多数の画素の信号を1つず つ順番に処理して出力するため(列並列信号処理)、画素数を増やすと信号出力に時間がかかり、フレームレー トを高めることが難しくなります。
とりわけ立体映像の撮影には、現在のデバイスをはるかに超え る画素数が必要になるため、フレームレートを維持できなくなることが懸念されます。
3次元構造撮像デバイスは、受光部や信号処理回路を備えた複数の基板を積層した構造で、画素ごとに信 号処理回路を持ち、並列して信号処理を行います(画素並列信号処理)。
画素数に関わらず1回の信号処理 で1画面を出力できるため、多画素化と高フレームレート化の両立が可能です。
我が国の閉塞感を打破するにはどうしたらよいか?
ヒントは身近なところにあるのかもしれない。 撮像デバイスである。
CCD(Charge Coupled Device:電荷結合素子)やCMOSイメージセンサーは我が 国が圧倒的な強みを有する分野である。
撮像デバイスは,8Kスーパーハイビジョンやさらなる高精細・高機 能を目指しており,今後も確実に進展が期待できる。
画素数増大を目指すという観点からは,撮像デバイスは More Mooreに近いようにも見える。
一方で,人々を引き付ける立体映像の撮像やさまざまな高機能化を実現 するには,新原理による各種デバイスや新機能の搭載が必須である。
撮像デバイスは,CMOSトランジスター の微細化による高速化と高集積化の恩恵を享受しつつも,微細CMOSデジタル回路による新機能搭載や,裏 面照射などの新構造導入も進めており,More Than Moore やBeyond CMOSも巻き込んで総力を挙げて撮像 デバイスの超高性能化に挑んでいるという感がある。
すなわち,最先端技術に対して大いなる期待感が存在し ている。そして,その技術で生み出された鮮明で印象に残る美しい映像が,今度は見る者に期待感とわくわく 感をもたらす。
(平本俊郎 東京大学生産技術研究所 教授)
(参考)超高画質8Kは5分で67GB!映画祭で見た知られざるVRの世界に迫る
(参考)人間の目と同じ解像度のVR/AR/XRディスプレイ「20|20」を発表した
Varjoのディスプレイは70メガピクセルで1メガピクセルのOculus、Vive、Hololens、Magic Leapなどと比べ、70倍の画質を誇っている。
次世代コンピューティングプラットホームとしてVarjoのプロダクトは2017年終わりごろにリリースされる予定だ。
(参考)北海道の絶景を、2億ピクセルを越える超高画質な360°パノラマVRで楽しめる「北海道VRツアー」 の公開と、そのデータのライセンス利用の開始
(参考)3D-HD(立体ハイビジョン)遠隔医療支援システム
遠隔医療センターが、高度な技術が要求される眼科手術の様子を、
顕微鏡に装着した左目用と右目用のビデオカメラ(1920×1080画素、フルカラー、30 frame/sec)によって立体HD動画像として撮影し、
それを遠隔地の医療機関へ高品質かつリアルタイムに伝送できるシステムを開発しました。
(参考)来年度の診療報酬の改定で遠隔診療の保険適用対象を広げる。
遠隔画像診断サービスの市場の概況
遠隔画像診断サービスは1990年代後半に市場が形成されて以降、一貫して右肩上がりで成長してきました。
国内におけるサービス提供事業者は60社程度で、
①全国展開を積極的に進めている一般企業系、
②関連施設・系列病院を主なユーザとする大学病院系(大学発ベンチャー、NPO法人)、
③特定の地域で展開する小規模事業者
などで構成されています。
2008年ごろから急成長している大学病院系の読影グループは、関連病院への非常勤医師の派遣に代わって、遠隔読影サービスの利用が増えたことを背景に成長してきました。
西尾 俊彦
電機業界を揺るがすパッケージ革命
西尾俊彦氏の講師紹介
1988年より: 日本アイ・ビー・エム株式会社。野洲研究所にて世界初となるオーガニック基板へのフリップチップ実現の熱応力理論を導入。
1993年より: 先端実装技術アプリケーション開発。世界最先端性能(当時)のウエアラブルグラスなどのパッケージ開発を統括。
2003年より: IBM Distinguished Engineer (技術理事)。IBMが新事業として開始した技術コンサルティングサービスのパッケージ部門を統括。
基幹のEthernetネットワークの速度も100GbEから400GbEへの高速化が求められる。
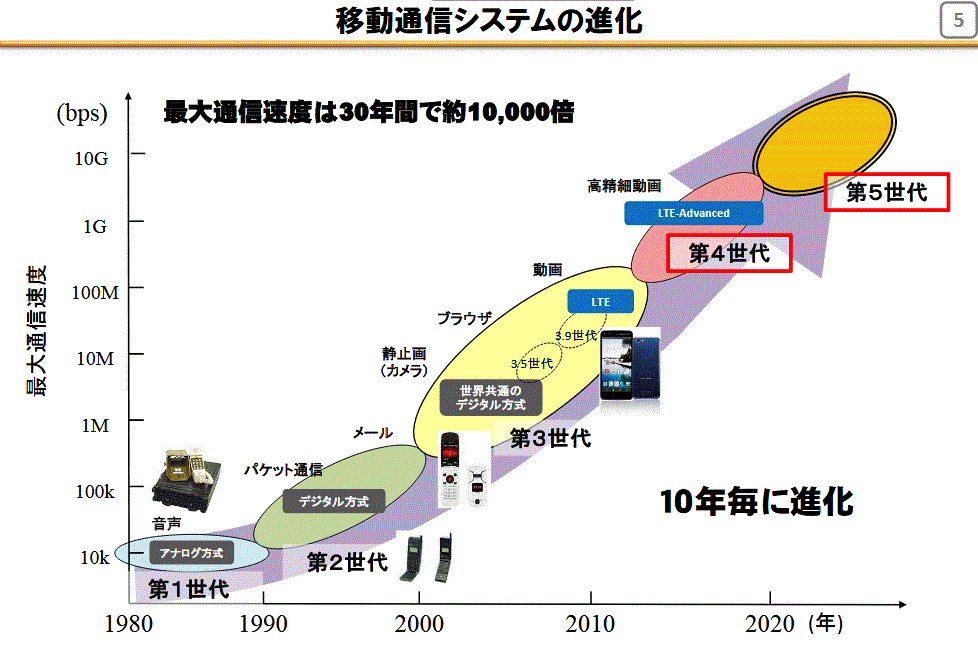
モバイル端末の分野でも、2020年までにメモリーのバンド幅を4倍以上に上げる必要があり、それを実現可能にするパッケージとしてFOWLP(Fan Out Wafer Level Package)に注目が集まっている。
FOWLPはフリップチップよりも電気特性が良く、薄型化した際の熱変形が少ないなどに優れたパッケージで、5年ほど前からモバイル端末用のRF、パワーアンプやベースバンドなどのIC向けに徐々に広がりを見せてきた。さらに、モバイル端末のアプリケーションプロセッサー(AP)にもFOWLPが採用される見込みとなり、いよいよモバイル端末用の半導体パッケージの主流になろうとしている。 電気特性や配線密度に優れたFOWLPは、自動運転に欠かせないレーダーには既に採用されており、次世代高速ネットワーク用途のマルチチップ構成にも開発が進むなど、さまざまなアプリケーションへの広がりを見せている。
一方、FOWLPの高性能化および薄型化を実現するファンアウト部分のコストが、現在の製造プロセスでは従来のフリップチップに比べてコスト高になっている。さらに、パッケージを支える役割であった基板が無くなることで、マザーボードからの応力の影響を受けやすくなるなどの懸念もある。
5G時代の半導体パッケージは技術もビジネスも激変
「5G時代の半導体を実現するパッケージ革命」の講師、西尾俊彦氏に聞く
iPhone7に採用されたFOWLP(Fan Out Wafer Level Package)は半導体のテクノロジーノードもメモリーバンド幅もそのままで、パッケージにより性能を1.4倍も引き上げた。FOWLPという優れたパッケージの導入により、ムーアの法則の終焉をパッケージが補完するというシナリオにおいて、大きなステップを示したことになる。
梶田 栄
スマートフォン(スマホ)の部品の村田製作所の世界シェア:
(電子回路のノイズを除去する「セラミックコンデンサー」はスマホに1台700個使われ、村田製作所の世界シェア4割だ。
通信制御に使う「SAWフィルター」で村田製作所が世界シェア5割を握る。)
ポストスマートフォンは?
スマートフォンの製品仕様の変化
IoT製品(自宅の見守り系センサー):窓の開閉状況や温度、湿度、照度、人感センサー、鍵の開閉状況。
IoTとは?
M2Mとは?
M2Mとセンサ
M2Mの全体像と市場
BLEの登場で一番のインパクトは低消費電力で動作可能なことだったが(機能や実装により異なってくるので一概には言えないが、ボタン電池1つで何ヶ月といった省電力性)、LPWAではさらにボタン電池で数年単位の動作を実現するという。
LPWA(Low Power, Wide Area)は、長距離伝送と低消費電力を特徴とするIoT(インターネット・オブ・シングス)向け通信技術の総称である。通信コストを現在のM2M(マシン・ツー・マシン)向け通信サービスの10分の1くらいまで下げられるかもしれないという期待もあり、注目を集めている。
既にフランスなどではSigfox社により全土にLPWAのネットワークが構築され、米国などでもLoRa規格によるLPWAの導入が始まっている(図表3-3-2-7)。
LPWA(Low-Power Wide Area)無線技術は、低い消費電力と長い通信距離が要求されることが多いIoT(Internet of Things)の実現を可能にします。
通信モジュール
電子部品の進化が携帯電話の小型化へ大きく寄与
極小セラミックコンデンサとは
極小電子部品の実装と課題
(参考)米クアルコム、5Gモデム搭載モバイル端末で毎秒ギガビット通信に成功
下石坂 望
IoT/IoE、ウエアラブル製品の急増にともなう多様な実装要求を克服する導電ペーストバンプによる低温ダメージフリー接合、かつ、狭ピッチ対応実装技術を研究しています。
コネクテックジャパンのコアテクノロジーであるMonster PAC技術は、従来技術の常識を覆す低温低荷重の実装技術であり、微細加工技術です。
また、Monster PAC技術によって、フリップチップボンダーをデスクトップサイズで実現できます。
そして、グローブボックスによる局所クリーン技術によって、高価なクリーンルームを不要にできます。
《 世界初10ミクロンピッチFCB 》
「世界唯一の技術、極低温・極低荷重のMonster PAC(r)で実現する10ミクロンピッチ接合」
(コネクテック、半導体実装工程を「卓上化」 - 低温低荷重接合で実現)
コネクテックジャパンは、パナソニック セミコンダクター社を退職した平田氏が2009年に設立。
国内大手メーカーの多くが半導体事業から撤退したことにより、リストラされた多くの技術者が力を発揮できない境遇に置かれているのが、現在の日本の状況であると指摘する平田氏。
「半導体業界の環境変化によって、技術力を持った30万人のリソースが今、国内にある。これは我々のようなベンチャー企業にとっては大きなチャンス」
と語り、そうした人材の積極的登用を行っていることも同社の特色であると強調する。
●先端半導体デバイスやMEMSにも適用可能なMONSTER PAC
○最先端の半導体実装課題を低温低荷重接合で解決
低温低荷重接合でこれまでなかったアプリケーションが可能になる
プロセス温度をさらに下げ、80℃にできれば、PETフィルム基板を含むほとんどすべての材料にフリップチップボンディングを適用できるようになる。このため現在は、接合温度80℃のプロセス開発を進めている。低温で確実に硬化する熱硬化性樹脂の開発がカギになるが、実現の見通しは立ってきているとしている。
(当ブログのコメント)
半導体部品が、卓上設備で製造できるようになると、今まで問題だった、半導体製造業界へ参入するための設備投資が高額という参入のハードルが低くなり、半導体産業が飛躍的に拡大する産業革命が起きるかもしれない。
その産業革命のトップにコネクテック社が位置していて、積極的に優秀技術者採用を進めているように見える。そのため、この時代にいる我々は、今後、コネクテック社が、ビルゲーツのマイクロソフト社の成長のように急速に成長するという、時代の変り目の変化を見ることになるかもしれない。
(参考)センサーの動向
センサーにおける小型化は、MEMS(微細加工)技術の活用で大きく前進している。デジタル気圧センサーでは、2×2.5×0.9ミリサイズ品が開発された。
ローパワーモード時1.8μAという低消費電流と高い検知精度(絶対圧力精度±0.05hPa)を達成している。
非接触温度センサーは、2.2ミリ角×0.9ミリサイズ品が登場。出力電圧は1ミリV。消費電流は2μA。
(参考)スマートグラス・スマートウォッチなどのウェアラブルデバイス業界において大本命と称されるイヤホン型の端末。
(参考)スマートグラスの肝は拡張現実(AR)にあり
2017年の世界ウェアラブルデバイス市場における腕時計型とリストバンド型の合計シェアは94.5%。腕時計型は、2021年までウェアラブル市場の大部分を占める見込みだ。手首装着型以外のウェアラブルでは、靴・衣類型と耳掛け型が急速に伸びるという。